在本系列第一篇文章中,我们展示了安捷伦串联四极杆 ICP-MS 仪器在半导体制造领域的检测能力,分享了其在检测超纯水、过氧化氢及矿物酸等水性制程化学品时的性能数据。本文将重点关注使用 Agilent 8900 半导体配置 ICP-MS/MS 或其前代产品 Agilent 8800 ICP-MS/MS 对有机化学品和试剂中的溶解态和颗粒污染物进行多元素测定。
有机制程化学品的多元素分析
在 IC 制造的多个工艺阶段中,有机试剂发挥着关键作用,典型应用场景包括:
- 清洗:异丙醇 (IPA)、N-甲基吡咯烷酮 (NMP)、甲醇、乙酸丁酯 (BuAc)
- 显影:丙二醇单甲醚 (PGME)、丙二醇甲醚乙酸酯 (PGMEA)、乳酸乙酯、NMP 和四甲基氢氧化铵 (TMAH)
- 蚀刻:二甲基亚砜 (DMSO) 和单乙醇胺 (MEA)
处理有机溶剂
虽然某些有机化学品可溶于水,但通常建议直接检测未经稀释的样品,以尽可能降低污染风险并实现更低的检出限。ICP-MS 适用于直接分析水溶性和非水溶性有机样品。对于非水溶性有机样品,可直接进样检测,或用合适的溶剂(如二甲苯或甲苯)稀释后检测。进行稀释检测时,可采用外标法进行校准,但由于样品粘度差异会导致雾化效率波动,半导体行业通常采用标准加入法 (MSA) 进行校准。
分析有机样品需要某些特定的 ICP-MS 硬件和操作条件,特别是进样系统和等离子体参数设置。8900 #200 ICP-MS/MS 专为半导体应用而设计,其配备耐腐蚀进样系统,包括以下核心组件:
- PFA 微流雾化器(流速:200 mL/min)
- 具有帕尔帖冷却功能的石英 Scott 双通道雾化室,温度范围 –5 °C 至 +20 °C
- 带有 2.5 mm 内径中心管的石英炬管(包括屏蔽炬系统)
- 铂尖接口锥
- 高传输率 s 透镜
8900 还配置有第五个质量流量控制器 (MFC),非常适合用于将氧气添加到载气中,从而有效防止碳沉积在采样锥上。此外,还可根据样品性质选用其他进样组件,例如对于强挥发性溶剂,推荐使用以下炬管:
- 可选的带有 1.5 mm 内径中心管的“有机”石英炬管(还提供带有 1.0 mm 内径中心管的炬管)。
溶解态和颗粒污染物分析
安捷伦 ICP-MS 和 ICP-MS/MS 系统提供快速、灵敏的纳米颗粒 (NP) 分析以及溶解态元素定量,为半导体实验室提供全面的分析解决方案。从 Agilent ICP-MS MassHunter 软件 5.2 版开始,分析人员可以设置单颗粒 (sp)ICP-MS 方法来监测每个样品的 NPs 中几乎不限数量的分析元素,如图 1 所示。在各自的理想条件下,依次测量不同的 NP 元素。

以下内容重点介绍了与高纯度有机试剂相关的各种应用,以及对这些试剂进行多元素 NP 分析的新需求。有关样品、试剂、仪器操作设置和方法条件的详细信息,可通过相应链接进行访问。
采用自动化标准加入 ICP-MS/MS 方法分析 IPA
IPA 是半导体制造中一种重要的有机溶剂,用于去除硅片表面的有机及金属残留物和杂质。本研究采用自动化标准加入系统(ASAS,IAS,日本东京)和 8900 ICP-MS/MS,通过在线标准加入法定量分析 IPA 中的痕量杂质元素。该方法能够准确可靠地定量分析 IPA 中的超痕量杂质,无需依赖技术精湛的分析人员。
将未经稀释的高纯度 IPA 样品引入 ICP-MS/MS 中,以尽可能降低污染风险并获得尽可能低的检出限 (DLs)。ASAS 自动制备并在线添加分析所需的所有校准(和加标)溶液。以 0、5、10、20 和 50 ppt 的浓度向 IPA 样品中加标。在针对 47 种目标元素的多重调谐方法中,使用了几种不同的反应池气体(He、H2、O2 和 NH3)。对于每个样品,每种模式下的数据将自动合并到一份报告中。
表 1a 和表 1b 所示为未经稀释的 IPA 中 47 种元素的 DLs 和背景等效浓度 (BECs)。利用空白(未加标)IPA 样品 10 次重复测定结果的标准偏差的 3 倍计算得出 DLs。SEMI 规定的所有 22 种元素的 DLs 和 BECs(表 1a)均远低于 100 ppt 的 4 级标准要求;许多元素甚至低于 0.1 ppt。这些结果表明,8900 ICP-MS/MS 具有出色性能,能够满足未来半导体制造对更高化学品纯度的要求。


使用通常首选的 Cu-63 同位素所报告的 Cu 的 BEC 出乎意料地高,达到 6.4 ppt。将该结果与使用二级同位素 65Cu 测得的 BEC 进行比较,发现两个实测浓度一致。这表明,使用 63Cu 所观察到的高 BEC 是由 IPA 样品中的痕量 Cu 污染造成的,并非是对 63Cu 存在任何干扰。
加标浓度为 20 ppt 的所有元素均获得了优异的加标回收率和重现性,这也表明该自动化 ASAS 方法适用于半导体有机制程化学品的常规分析。
如图 2 所示(数据源自安捷伦 ICP-MS 期刊,第 78 期),使用 8900 ICP-MS/MS 在 MS/MS 模式下通入 H2 反应池气体时,P 元素的 BEC 可低至 7.7 ppt。
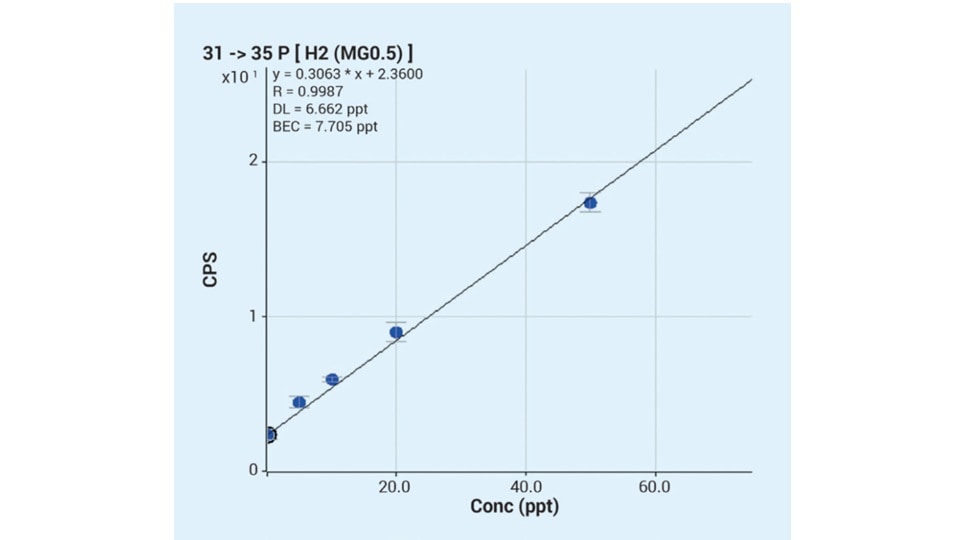
半导体级 NMP 中溶解态和颗粒物污染的超痕量分析
电子级 N-甲基吡咯烷酮 (NMP) 具有优异的溶解性能,在半导体行业中广泛应用于晶圆清洗和光刻胶剥离。本研究使用 8900 ICP-MS/MS,对日本富士胶片和光纯药株式会社提供的 EL(用于电子行业)和 SP(Supreme Pure,超纯)级 NMP 样品中的溶解态污染物和 NPs 进行了检测。使用 MSA 定量分析 54 种溶解态元素的浓度,其中包括 SEMI C33-0213 中列出的所有 22 种元素。
半导体制造商和化学品供应商还必须控制 NMP 等试剂中的颗粒物污染,特别是可能导致电路缺陷和设备故障的金属颗粒,包括 NPs。NPs 可能来自于原料和工艺设备。
在初步筛查采集以识别潜在的颗粒污染物后,建立多元素 NP 方法,使用 8900 在 spICP-MS 模式下测量两种级别的 NMP 中涉及 14 种元素的颗粒。图 3 显示了在两种样品中测得的颗粒中检测到的元素的粒径分布。SP 级样品中的颗粒数量更少并且不包含大颗粒,证明这种高品质试剂具有更高的纯度。
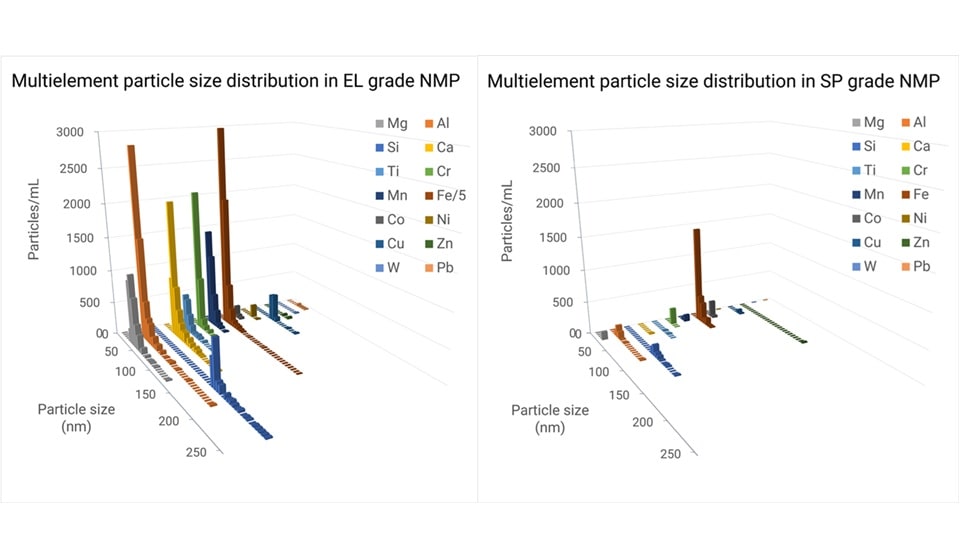
克服 NMP 中硫、磷、硅和氯元素痕量分析中的质谱干扰问题
在测定 NMP 中的非金属杂质(如硫、磷、硅和氯)这类具有挑战性的应用中,ICP-MS/MS 通常比单四极杆系统(如 Agilent 7900s ICP-MS)更具优势。
本研究介绍了使用 8800 ICP-MS/MS 检测这些具有挑战性的杂质的方法开发过程。这些元素的电离效率较低,进而大大降低了分析元素信号强度,与此同时,NMP 基质中的 N、O 和 C 元素形成的多原子离子干扰导致背景信号升高(未经干扰校正的 BEC 值),使这些元素的痕量检测更加雪上加霜(见表 2)。表 2 所示 ICP-MS/MS BECs 和 DLs 为使用质量转移方法获得的 BECs。除 Cl 元素以外,其他所有分析元素均以氧气作为反应池气体。除 Cl 以外,其他所有分析元素的检出限均处于中低 ppt 范围。Cl 元素检测受限是由于其电离度非常低。尽管如此,仍获得了低 ppb 级检出限。在常规分析中可设置自动化方法,通过单次进样即可测定所有分析元素。

有关如何通过 ICP-MS/MS 测定 20% 超纯甲醇中的硅、磷和硫的详细信息,请参见另一篇文章。其中包括用于测量这三种元素的优化 MS/MS 参数设置说明。
在单次分析运行中表征 TMAH 中的 Ag、Fe3O4、Al2O3、Au 和 SiO2 NPs
ICs 光刻过程会用到光刻胶,而 TMAH 是光刻胶显影中广泛使用的碱性溶剂。本研究使用 8900 在 spICP-MS/MS 模式下测定了半导体级 TMAH 中的多元素 NPs,包括 Ag、Fe3O4、Al2O3、Au 和 SiO2。
使用多元素 spICP-MS 方法对空白 TMAH 和加标了 NPs 的 TMAH 溶液进行测量。图 4 汇总了 1% TMAH 中多元素 NPs 的粒径数据。蓝色直方图表明 NPs 存在于未加标的(原始)TMAH 溶液中。绿色直方图表明 NPs 存在于加标的 TMAH 溶液中。结果表明,即使在混合 NP TMAH 溶液中,均单独检测出了所有五种 NPs。使用多元素 spICP-MS 方法,即使存在大颗粒(例如 200 nm SiO2),也能明确测定小颗粒(例如 30 nm Fe3O4),并获得良好的准确度。

测定有机溶剂中低颗粒浓度的 Fe3O4 NPs
在集成电路 (ICs) 制造过程中,使用的试剂产生的金属 NPs,尤其是 Fe 基 NPs,可能导致晶圆表面出现“锥形缺陷”,从而造成电信号短路。在本研究中,安捷伦应用工程师和行业科学家评估了使用 Agilent 8900 ICP-MS/MS 在 spICP-MS 模式下测定 IPA、PGMEA 和 BuAc 三种常用有机溶剂中的 25 nm 或 30 nm Fe3O4 NPs 的可行性。如图 5 所示,所有溶剂中 30 nm Fe NPs(加标浓度 5 ppt)产生的信号可与背景信号明显区分。此外,在所有加标溶剂中,实测的平均颗粒粒径约为 30 nm,与 Fe NP 的标称直径 (30 nm) 一致。本研究还表明,在 spICP-MS 模式下,8900 ICP-MS/MS 可检测 IPA 溶液中浓度低至 0.1–2 ppt 的 25 nm Fe NPs。

在后续研究中,分析人员进一步证实,8900 ICP-MS/MS 在 spICP-MS 模式下可成功测定 IPA、PGMEA 和丙二醇单甲醚 (PGME) 中添加的 15 nm Fe2O3 NPs (Sigma Aldrich)。
聚焦晶圆分析、气体和高级半导体应用
Agilent 8900 ICP-MS/MS 具有低背景、高灵敏度,并能有效控制质谱干扰,为分析有机试剂中的溶解态污染物和颗粒物成分提供了出色性能。在下一期 ICP-MS 期刊中,我们将探讨 ICP-MS/MS 仪器在晶圆、气体和其他高级分析中的重要作用。
了解更多信息:
DE-007672