自 20 世纪 90 年代初以来,安捷伦一直与前沿的半导体制造商和化学品供应商密切合作,这种合作关系至今仍在蓬勃发展。从离轴离子透镜和冷等离子体屏蔽炬系统到具备 MS/MS 操作模式的独特高灵敏度 Agilent 8900 ICP-MS/MS,行业需求的不断演变推动了安捷伦在 ICP-MS 技术领域的多项关键创新。作为系列文章的第一篇,本文重点介绍了使用 8900 半导体配置 ICP-MS/MS 对水性制程化学品中的超痕量污染物进行多元素测定。
在集成电路制造的各个环节监测痕量金属
半导体器件制造过程中需要严格控制污染源,以确保微芯片的稳定性和良率。金属污染物是重点关注对象,因为它们会通过降低介质击穿电压等原因而影响成品器件的电气性能。无机污染物的主要来源包括晶圆衬底以及集成电路 (ICs) 制造过程中使用的化学品和试剂。
水性制程化学品的多元素分析
在 IC 制造过程中,晶圆经过许多工艺步骤,如图 1 所示。
在控制污染方面,最关键的制程化学品包括超纯水 (UPW) 和 RCA 标准清洗 (SC) 溶液 SC-1 和 SC-2。RCA 清洗步骤除去晶圆表面的化学污染物和颗粒物杂质,而不损伤芯片。SC-1(NH4OH 和 H2O2 的去离子水溶液)用于除去晶圆表面的有机残留物、膜和颗粒。然后用 SC-2(HCl 和 H2O2 的去离子水溶液)除去离子型污染物。
有机物(例如光刻胶聚合物图案)必须在离子注入后从硅晶圆表面完全除去。该清洗步骤使用硫酸-过氧化物混合物 (SPM)“食人鱼”溶液进行,食人鱼溶液为 H2SO4 和 H2O2 的混合物。确保这些化学品中金属杂质含量处于极低水平对于避免晶圆表面在制造过程中受到污染至关重要。
HNO3 在半导体器件的制造过程中也发挥着重要作用。例如,HNO3 和 HF 混合物会用于蚀刻单晶硅和多晶硅。HNO3 与磷酸及乙酸混合还可用于湿法蚀刻铝。
性能验证研究
许多前沿的半导体制造商会在其生产设施和实验室中使用多套安捷伦 ICP-MS 系统。自安捷伦 2016 年推出 8900 ICP-MS/MS 以来,其已被广泛应用于根据 SEMI 指南分析上述多种化学品和试剂,以下为部分示例。该仪器通常配置一个 MicroFlow 雾化器(流速:200 µL/min)、一个石英进样系统(带可选的气体端口)、铂接口锥、一个 s 透镜和具备轴向加速功能的 ORS4。
检测超纯水中的 ASTM/SEMI 元素,达到单 ppt 和亚 ppt 级检测要求
本研究证明,配备可选 m 透镜的 8900 ICP-MS/MS 适用于测定超纯水中的超痕量污染物。m 透镜能够尽可能降低易电离元素 (EIEs) K、Na、Ba 和 Li 的背景信号,从而可以使用热等离子体条件(CeO/Ce 比值 < 2%)测定 ppt 级的 26 种 SEMI 关键元素。通过在 MS/MS 模式下运行 8900,并采用单一多重调谐方法(无气体和两种反应气体模式),成功消除所有潜在的谱图干扰。
如图 2 所示,所有元素的 BECs 和 DLs 均远低于 ASTM 和 SEMI 针对半导体行业制造(线宽 < 0.045 μm)中使用的超纯水所规定的建议值。除硼之外,所有元素都低于 0.5 ppt。不过,正如上一期《ICP-MS 期刊》中所发表的一篇文章所述,使用 8900 和配备硼过滤器的 Organo Puric ω II 系统,硼的 BEC 和 DL 可分别改善至 0.63 和 0.12 ppt。

SEMI 5 级高纯过氧化氢
本研究使用 TAMAPURE-AA-10 过氧化氢 (35%) 作为样品基质。为稳定加标元素,将超纯 HNO3 (TAMAPUREAA-10) 加入到 H2O2 样品中,所用比例为 1 份 70% HNO3 对 1000 份样品,最终得到的酸浓度为 0.07%。配制混合多元素标准溶液 (SPEX CertiPrep, NJ, US),并将其以 10、20、30、40、50 ppt 的浓度加标至空白 H2O2 基质中,获得标准加入校准溶液。溶液在临分析前进行配制。
表 1 中显示了 H2O2 中测得的 SEMI 元素的定量结果和检出限,其中包括硫 (S) 和磷 (P)。对于 SEMI 标准中未规定的元素的分析结果,请参阅应用简报。各个检出限根据空白 H2O2 样品 10 次重复测量结果计算得出,并以 3σ 表示。
根据 SEMI C30-1110 5 级标准,所列元素的最高允许浓度为 10 ppt。因此,除硫的加标浓度为 100 ppt 以外,其他分析物元素的加标浓度均为 10 ppt。在持续 3 小时 40 分钟的高纯度 35% H2O2 样品分析序列中,加标分析物在 10 ppt(S 为 100 ppt)浓度下获得了 1.0%–8.1% RSD 的重现性。

另一项研究使用 8900 ICP-MS/MS 解决了超纯水中非金属杂质 P、S、Si 和 Cl 以及 H2O2 中非金属杂质 P、S 和 Si 的谱图干扰问题。表 2 中的结果表明,8900 ICP-MS/MS 对这些挑战性元素具有超强分析性能,在检测这些元素时实现了极低的 BECs,尤其对于超纯水样品。

高纯度盐酸中的痕量金属杂质
半导体级 HCl 为 37%–38%,相比之下,商品级 HCl 为 20% 或 36%(如本研究中所用)。在各种等级的 HCl 中,非常高的氯化物基质导致形成多种多原子离子,从而对一些关键元素造成显著的谱图干扰。例如,H237Cl+ 对 39K+ 的干扰、35Cl16O+ 对 51V+ 的干扰、35Cl16OH+ 对 52Cr+ 的干扰、37Cl16O+ 对 53Cr+ 的干扰、35Cl37Cl+ 对 72Ge+ 的干扰、37Cl2+ 对 74Ge+ 的干扰和 40Ar35Cl+ 对 75As+ 的干扰。本研究使用在多种调谐模式下运行的 8900 ICP-MS/MS,通过标准加入 (MSA) 法总共测量了 50 种元素,包括所有 SEMI 标准 C27-0708 C 级规格分析物。20% HCl 中的所有 50 种元素均获得了个位数的 ppt 或亚 ppt 级 DL 和 BEC。每个样品在每种调谐模式下获得的定量数据将自动合并到一份报告中。表 3 显示了通过 MSA 测得的高纯度 20% HCl 中所有 SEMI 规定元素的定量数据。即使在考虑酸浓度百分比差异的情况下,结果表明,8900 ICP-MS/MS 能够检测到的污染物浓度远低于 SEMI C27-0708 中针对高纯度半导体级 HCl 所规定的浓度。

注:砷 DL 采用不同的高纯级 HCl(用 DIW 将 34% 高纯级 HCl 稀释至 20%)测得,因为原始样品疑似受到该元素的污染。As 污染通过 m/z 91 和 93 处测得的子离子质谱图得到确认。详见此安捷伦出版物。
超纯半导体级硫酸中痕量元素的测定
本研究使用 8900 ICP-MS/MS,在多种调谐模式下使用 MSA 校准测定了 42 种元素。使用超纯水将 98% 高纯 H2SO4 (TAMA Chemicals Co. Ltd. Japan) 稀释十倍。如果常规分析稀释十倍的硫酸,建议安装大尺寸 (18 mm) 内插铂采样锥。安装干泵选件和球型接口阀套件,可以尽量避免内部 ICP-MS 组件的长期腐蚀。多元素标准溶液使用 XSTC-331、XSTC-7、XSTC-8 (SPEX CertiPrep, USA) 和 Si 单元素标准品 (Kanto Chemical Co., Inc., Japan) 进行配制。
除 Si (44 ppt)、P (3 ppt) 和 Zn (1.5 ppt) 之外的其他元素均达到了亚 ppt 级检出限。检出限通过空白 9.8% H2SO4 的 10 次重复测量结果计算得到。9.8% H2SO4 的定量分析结果 (BECs) 如表 4a 和 4b 所示。通过对 20 ng/L 的 9.8% H2SO4 加标溶液重复测量 10 次来确定回收率和 RSD。包括 Ti、V 和 Zn 在内的所有元素均获得了优异的性能,这表明通过使用 8900 方法,S 类基质干扰物得到了有效抑制。


高纯硝酸中痕量金属杂质的直接分析
利用 8900 ICP-MS/MS 直接分析未稀释的商品级 (61%–68%) HNO3。直接分析可简化样品前处理,并避免在稀释过程中引入污染物。本研究使用在多种调谐模式下运行的 8900 总共测量了 49 种元素,在每个样品瓶的单次进样过程中自动切换调谐模式。所有 SEMI 目标元素均获得了良好的线性和亚 ppt 级检出限。Na、K、Ca 和 Fe 的代表性标准加入校准曲线如图 3 所示。所有 49 种元素的测定结果均明显低于 SEMI 标准 C35-0708 B 级所规定的 69%–70% HNO3 的 1 µg/L (ppb) 最大限量。
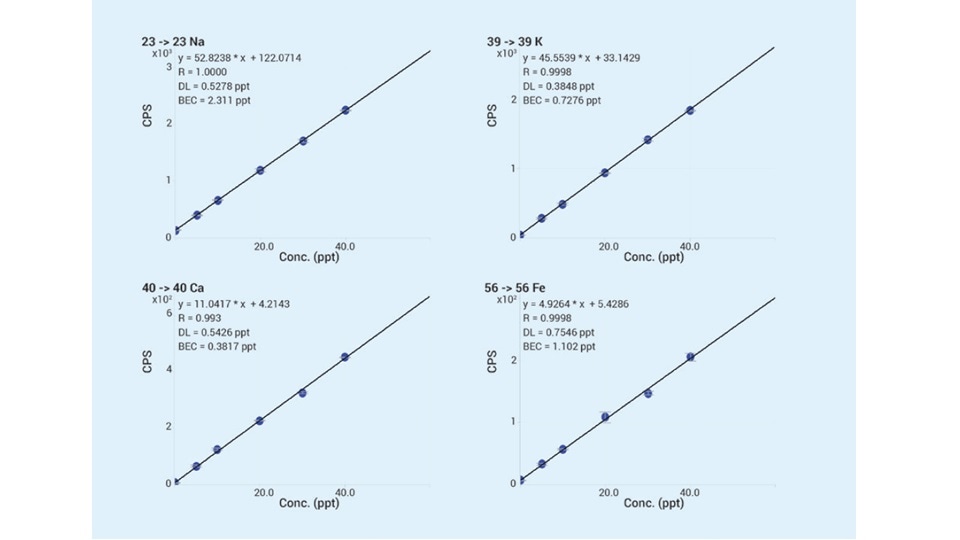
对非水性基质的检测性能如何?
在 MS/MS 模式下运行的 Agilent 8900 ICP-MS/MS 能够为水性制程化学品的超痕量元素分析提供所需的高灵敏度、低背景,并能有效控制干扰。在第 2 部分中,我们将了解 8900 ICP-MS/MS 如何应对高纯度有机试剂。
了解更多信息:
DE-003355